WIRE-BONDING
Method of connection between the pads of the circuit and the pins of the encapsulation employing conductive wires (usually aluminum or gold).
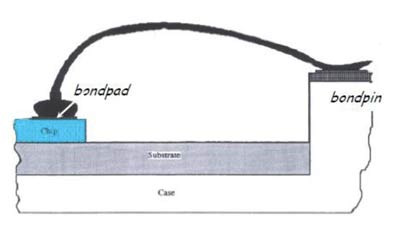
WIRE-BONDING EQUIPMENT
SEMI AUTOMATIC WIRE BONDING TPT HB16
AUTOMATIC WIRE BONDING
TPT HB16
Thermosonic WireBonder
HB16 is a manual/semiautomatic thermosonic wire bonder for Wedge bonding, Ball bonding andBall Bumping. This wire-bonder counts with Motorized Z and Y-Axis and more than 100 Program Storage Capacities and is ideal for laboratories, pilots, and small-scale production lines.
Bonding Methode:
Wedge-Wedge, Ball-Wedge, Ribbon- & Bumb – bonding
Gold wire diameter:
17 – 75µm (0,7 -3mil)
Aluminium wire diameter:
17 – 75µm (0,7 – 3mil)
Ribbon size:
max. 25 x 250 µm (1 x 10 mil)
Ultrasonic system:
63.3 kHz Transducer PLL Control
Utrasonic power:
0–10 Watt Output
Bond time:
0-20000 msec.
Bond force:
5 – 150 cN (350 cN option)
Bonding tool:
1.58 Ø 19 mm length (0.0624” x 0.750”)
Deep-Access:
Wedge16 mm /Ball13 mm
Bond Arm Length:
165 mm

