DIE-BONDING
NO TENEMOS DEFINICIÓN NI FOTO. The marking and cutting process separates the chips that make up the processed wafer. Usually, the dicing process need a machine called a dicing saw or laser cutting.
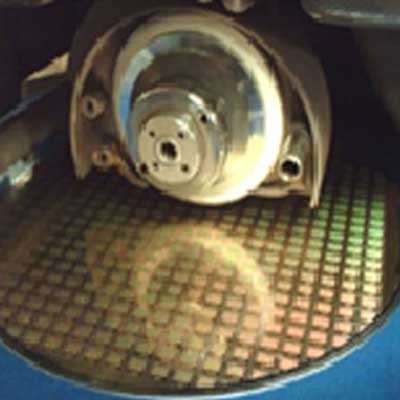
DIE BONDING EQUIPMENT
PACTECH SB2M
ATV SOLDER RELOW OVEN SRO 704
PACTECH SB2M
It is a semiautomatic solder ball placement reflow/rework machine designed for small volume manufacturing, prototyping, and research and development. The ball diameters range from 150μm to 760μm. Visual inspection is accomplished using a high-resolution five-step-zoom stereo microscope.
Axis (travel range):
Piezo linear motors
X,Y Axis: 100mm x 100mm (4-inch)
Work area: 150mm x 100mm
Z Axis: 50mm
Ball Placement Rate and Reflow Specified Depending on Layout:
3 balls/sec.
Laser Specifications:
Wavelength: 1064nm
Laser Energy (max.): 0,4J in 10ms
Pulse Widths (Cont. adjust): 1ms – 20ms
Pilot Diode Laser:
0W (1085nm)
Stability ±5%

