DICING
The marking and cutting process separates the chips that make up the processed wafer. Usually, the dicing process need a machine called a dicing saw or laser cutting.
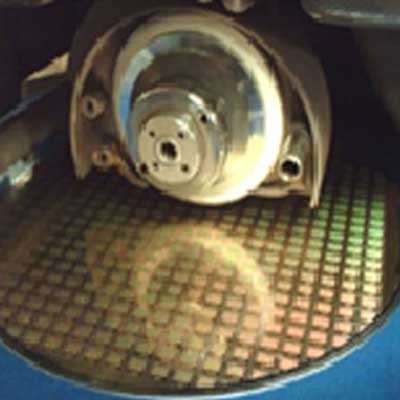
DICING EQUIPMENT
DICING SAW DAD 3350
CLEANING SYSTEM DCS1440
DICING SAW DAD 3350
The dicing saw DAD3350 can cut the next materials: glass, Si, SOI, Silica glass, Al, and AlNi. The equipment supports for blades of up to Φ5 inches. This equipment has a spindle front-section support structure, which prevents heat shrinkage and vibration.
Spindle layout:
Single
Workpiece size:
Max: ø8″ or 250 mm x250 mm
X-axis:
Cutting range: 260mm
Cut speed: 0.1 – 600 mm/s
Y-axis:
– Cutting range: 260 mm
– Index step: 0.0001 mm
– Single error: 0.002 or less/5 mm
-Positioning accuracy: 0.003 or less/260 mm
Z-axis:
Maximum stroke: 32.2 mm
Moving resolution: 0.00005 mm
Repeating accuracy: 0.001 mm
Maximum blade size: ø58 mm
θ-axis:
Maximum rotating angle: 380 deg.
Spindle:
Rated torque: 0.29 Nm
Rotation speed range: 6000 – 60000 min-1

